Principios fundamentales de la soldadura BGA
La soldadura BGA consiste en unir esferas de soldadura a las almohadillas del chip. A continuación, el chip se coloca boca abajo sobre la placa de circuito impreso (PCB). Se aplica calor y presión para fundir las esferas de soldadura, que se unen a las almohadillas de la PCB, completando así el proceso de soldadura. En comparación con las técnicas de soldadura tradicionales, la soldadura BGA permite una mayor densidad de uniones, reduce la pérdida de potencia durante la soldadura y mejora la fiabilidad del proceso. Además, ofrece un rendimiento térmico y eléctrico superior, junto con una mayor resistencia mecánica, lo que la hace idónea para la transmisión de señales de alta velocidad y aplicaciones de alta frecuencia.
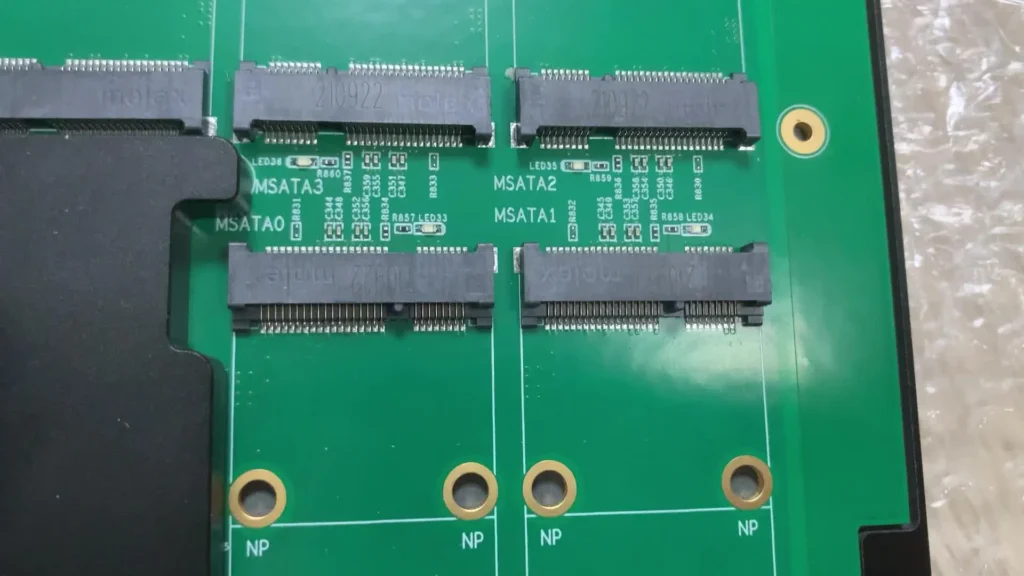
Flujo del proceso de soldadura BGA
El proceso de soldadura BGA comprende preparación, desoldadura, limpieza, estañado, unión de pads, colocación del chip, soldadura por reflujo y enfriamiento. Durante la preparación, se inspeccionan las dimensiones y la calidad de los pads y las esferas, se confirman los parámetros de soldadura y se reúnen las herramientas y los materiales necesarios.

El desoldado elimina las esferas de soldadura antiguas de las almohadillas mediante pistolas de aire caliente o placas calefactoras. La limpieza elimina los residuos y contaminantes del desoldado para garantizar la limpieza de las almohadillas. El estañado deposita nuevas esferas de soldadura en las almohadillas, controlando la cantidad y la colocación. El montaje de chips coloca los chips soldados en las placas de montaje para su posterior colocación y soldadura. La colocación del chip implica invertir el chip con las esferas de soldadura sobre la PCB, asegurando una alineación precisa entre el chip y la PCB. La soldadura por reflujo utiliza aire caliente o calentamiento infrarrojo para fundir las esferas de soldadura y unirlas a las almohadillas, lo que requiere un control preciso de la temperatura y el tiempo. El enfriamiento es el proceso de llevar el chip soldado a temperatura ambiente, garantizando la estabilidad y fiabilidad de la unión de soldadura.
Cuáles son bolas de soldadura BGA?
Las esferas de soldadura son productos esféricos de soldadura fabricados mediante técnicas de fusión, atomización/goteo y selección/clasificación de materia prima de alta pureza. Se caracterizan por un diámetro uniforme (con una tolerancia de ±0,02 mm) y una excelente redondez, por lo que se utilizan ampliamente en el encapsulado BGA y la soldadura microelectrónica para mejorar la precisión del encapsulado y garantizar conexiones fiables entre el chip y la placa.
Compuestas principalmente de estaño, plata y cobre de alta pureza, estas esferas se utilizan en placas base de servidores, tarjetas gráficas y chips para teléfonos inteligentes. Evitan fallos de conexión en el encapsulado BGA, soldaduras irregulares en la soldadura microelectrónica e interferencias de señal en la soldadura de chips de alta frecuencia.

1. Micropuentes debajo del chip
Las esferas de soldadura BGA son microesferas metálicas dispuestas bajo el chip, con un diámetro que suele oscilar entre 0,2 y 0,76 milímetros. Estas esferas de aleación de estaño funcionan como microinterruptores: se funden durante el funcionamiento y se solidifican formando conexiones eléctricas permanentes al enfriarse. En comparación con los pines tradicionales, este diseño permite cientos de puntos de conexión por chip con una separación de tan solo 0,4 milímetros.
2. Maestros de la Termodinámica Bailarines
Las bolas de soldadura exhiben propiedades notables durante la soldadura por reflujo:
Control de la tensión superficial: Se autoalinean con las almohadillas como gotas de mercurio cuando están fundidas.
Capacidad de autocorrección: Las pequeñas desalineaciones se realinean automáticamente mediante el flujo de metal líquido.
Compensación de la dilatación térmica: Las formulaciones de aleaciones especiales amortiguan las diferencias de dilatación/contracción térmica entre el chip y la PCB.
3. Esferas diminutas, gran impacto
Este diseño introduce tres cambios revolucionarios:
- El chip 60% aumenta la utilización del espacio, permitiendo smartphones más delgados.
- Menores distancias de transmisión de señal, lo que permite mayores velocidades de procesamiento.
- Una mayor resistencia a los golpes reduce significativamente las tasas de fallos en la electrónica automotriz.
Lo más interesante es que la tensión superficial de las bolas de soldadura fundidas forma arcos perfectos de forma natural. Esta propiedad óptica inherente se utiliza incluso para calibrar ciertos sensores.
BGA es un encapsulado de montaje superficial donde protuberancias esféricas reemplazan a los pines en una matriz dispuesta en la cara posterior de la PCB. Los chips LSI se montan en la cara frontal de la PCB y luego se sellan mediante resina moldeada o encapsulado.
Características
• Mayor número de pines y paso más fino con menor espacio de montaje
• Rendimiento térmico y eléctrico superior
• Compatible con procesos SMT
• Bajo coste de fabricación y alta fiabilidad
Luoyang Qiancai Industrial ofrece alta pureza Bolas de soldadura BGA, garantizando que las bolas de soldadura cumplan con los requisitos de precisión que usted necesita.