Principes fondamentaux du brasage BGA
Le brasage BGA consiste à fixer des billes de soudure sur les pastilles de la puce. La puce est ensuite placée face contre la carte de circuit imprimé. La chaleur et la pression appliquées permettent de faire fondre les billes de soudure, qui se lient alors aux pastilles de la carte, achevant ainsi le processus de brasage. Comparé aux techniques de brasage traditionnelles, le brasage BGA permet une densité de soudure plus élevée, réduit les pertes de puissance et améliore la fiabilité du brasage. Il offre également des performances thermiques et électriques supérieures, ainsi qu'une résistance mécanique accrue, ce qui le rend adapté à la transmission de signaux à haut débit et aux applications haute fréquence.
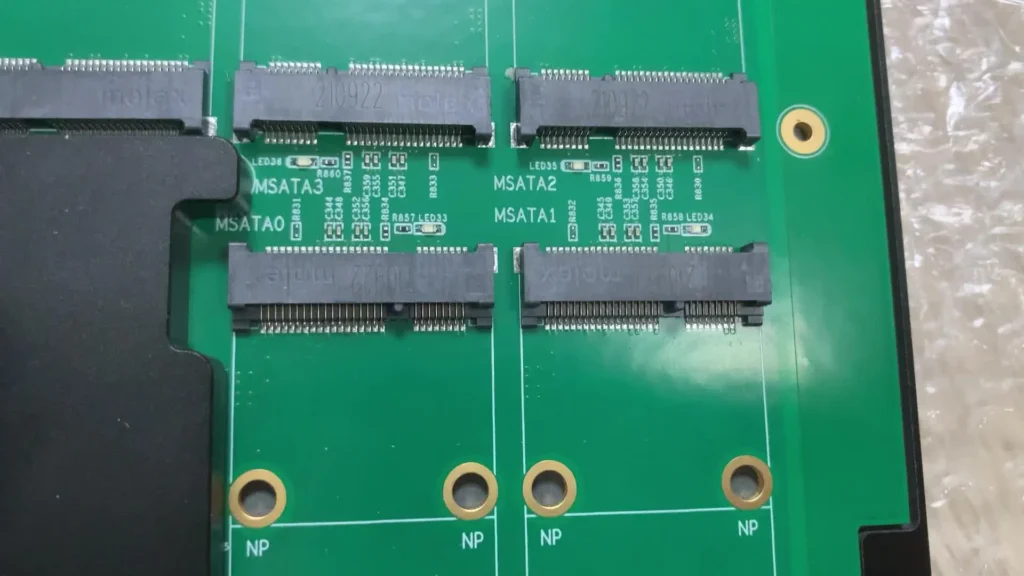
Processus de soudage BGA
Le processus de brasage BGA comprend la préparation, le dessoudage, le nettoyage, l'étamage, le collage des pastilles, le placement de la puce, le brasage par refusion et le refroidissement. Lors de la préparation, les dimensions et la qualité des pastilles et des billes sont contrôlées, les paramètres de brasage sont vérifiés et les outils et matériaux nécessaires sont rassemblés.

Le dessoudage consiste à retirer les anciennes billes de soudure des pastilles à l'aide d'un pistolet à air chaud ou d'une plaque chauffante. Le nettoyage élimine les résidus de dessoudage et les contaminants afin de garantir la propreté des pastilles. L'étamage consiste à déposer de nouvelles billes de soudure sur les pastilles en contrôlant la quantité et l'emplacement. Le montage des puces consiste à positionner les puces soudées sur les cartes de montage en vue de leur placement et de leur soudage ultérieurs. Le placement de la puce consiste à retourner la puce, fixée par ses billes, sur le circuit imprimé, en assurant un alignement précis entre la puce et le circuit imprimé. Le brasage par refusion utilise de l'air chaud ou un chauffage infrarouge pour faire fondre les billes de soudure et les fixer aux pastilles, ce qui exige un contrôle précis de la température et du temps. Le refroidissement est le processus qui consiste à ramener la puce soudée à température ambiante, assurant ainsi la stabilité et la fiabilité des joints de soudure.
Que sont billes de soudure BGA?
Les billes de soudure sont des produits de soudure sphériques fabriqués à partir de matières premières de haute pureté, par fusion, atomisation/dépôt et tri. Caractérisées par un diamètre uniforme (tolérance de ±0,02 mm) et une excellente rondeur, elles sont largement utilisées dans le packaging BGA et le brasage microélectronique pour améliorer la précision du packaging et garantir des connexions fiables entre la puce et la carte.
Composées principalement d'étain, d'argent et de cuivre de haute pureté, ces billes sont utilisées dans les cartes mères de serveurs, les cartes graphiques et les puces de smartphones. Elles préviennent les défauts de connexion dans les boîtiers BGA, les soudures irrégulières en microélectronique et les interférences de signal lors du soudage de puces haute fréquence.

1. Micro-ponts sous la puce
Les billes de soudure BGA sont des microsphères métalliques disposées sous la puce, d'un diamètre généralement compris entre 0,2 et 0,76 millimètre. Ces billes en alliage d'étain fonctionnent comme des ponts miniatures : elles fondent en fonctionnement et se solidifient en refroidissant, formant ainsi des connexions électriques permanentes. Comparée aux broches traditionnelles, cette conception permet d'obtenir des centaines de points de connexion par puce, avec un pas aussi fin que 0,4 millimètre.
2. Les maîtres de la thermodynamique dansante
Les billes de soudure présentent des propriétés remarquables lors du brasage par refusion :
Contrôle de la tension superficielle : s’auto-alignent sur les coussinets comme des gouttelettes de mercure lorsqu’elles sont fondues.
Capacité d'autocorrection : les légers défauts d'alignement se corrigent automatiquement par flux de métal liquide.
Adaptation de la dilatation thermique : Des formulations d’alliages spéciales compensent les différences de dilatation/contraction thermique entre la puce et le circuit imprimé.
3. Petites sphères, grand impact
Ce design apporte trois changements révolutionnaires :
- L'utilisation accrue de l'espace grâce à la technologie 60% permet de concevoir des smartphones plus fins.
- Des distances de transmission du signal plus courtes, permettant des vitesses de traitement plus élevées
- Une résistance accrue aux chocs réduit considérablement les taux de défaillance des composants électroniques automobiles.
Plus étonnant encore, la tension superficielle des billes de soudure en fusion forme naturellement des arcs parfaits. Cette propriété optique intrinsèque est même exploitée pour l'étalonnage de certains capteurs.
Le BGA est un boîtier à montage en surface où des plots sphériques remplacent les broches selon un motif matriciel sur la face arrière du circuit imprimé. Les puces LSI sont montées sur la face avant du circuit imprimé, puis scellées à l'aide de résine moulée ou par enrobage.
Caractéristiques
• Nombre de broches plus élevé et pas plus fin avec un encombrement réduit
• Performances thermiques et électriques supérieures
• Compatible avec les procédés SMT
• Faibles coûts de fabrication et grande fiabilité
Luoyang Qiancai Industrial fournit des produits de haute pureté Billes de soudure BGA, en veillant à ce que les billes de soudure répondent aux exigences de précision dont vous avez besoin.