Principi fondamentali della saldatura BGA
La saldatura BGA prevede l'incollaggio di sfere di saldatura alle piazzole del chip. Il chip viene quindi posizionato capovolto sul PCB. Calore e pressione vengono applicati per fondere le sfere di saldatura, che poi vengono collegate alle piazzole del PCB, completando il processo di saldatura. Rispetto alle tecniche di saldatura tradizionali, la saldatura BGA consente una maggiore densità di giunzione, riduce la perdita di potenza durante la saldatura e ne migliora l'affidabilità. Offre inoltre prestazioni termiche ed elettriche superiori, insieme a una maggiore resistenza meccanica, rendendola adatta alla trasmissione di segnali ad alta velocità e ad applicazioni ad alta frequenza.
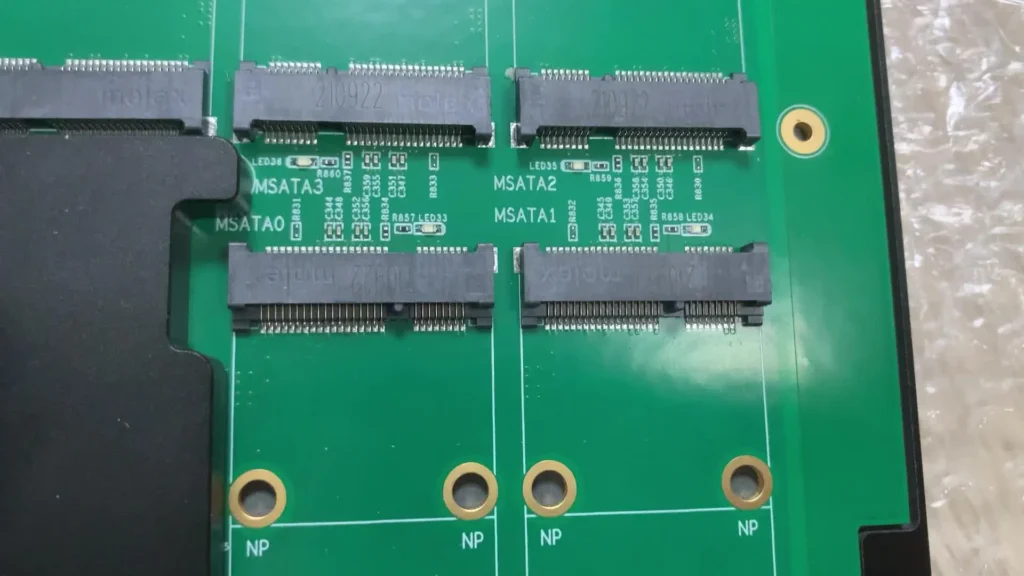
Flusso del processo di saldatura BGA
Il processo di saldatura BGA comprende preparazione, dissaldatura, pulizia, stagnatura, incollaggio dei pad, posizionamento dei chip, saldatura a rifusione e raffreddamento. Durante la preparazione, vengono ispezionate le dimensioni e la qualità dei pad e delle sfere, vengono confermati i parametri di saldatura e vengono assemblati gli utensili e i materiali necessari.

La dissaldatura rimuove le vecchie sfere di saldatura dalle piazzole utilizzando pistole ad aria calda o piastre riscaldanti. La pulizia elimina i residui di dissaldatura e i contaminanti per garantire la pulizia delle piazzole. La stagnatura deposita nuove sfere di saldatura sulle piazzole controllandone quantità e posizionamento. Il montaggio del chip posiziona i chip saldati sulle schede di montaggio per il successivo posizionamento del die e la saldatura. Il posizionamento del die comporta l'inversione del chip con le sfere sul PCB, garantendo un allineamento preciso tra chip e PCB. La saldatura a riflusso utilizza aria calda o riscaldamento a infrarossi per fondere le sfere di saldatura e fissarle alle piazzole, richiedendo un controllo preciso della temperatura e del tempo. Il raffreddamento è il processo che riporta il chip saldato a temperatura ambiente, garantendo stabilità e affidabilità del giunto di saldatura.
Cosa sono Sfere di saldatura BGA?
Le sfere di saldatura sono prodotti di saldatura sferici realizzati mediante tecniche di fusione, atomizzazione/gocciolamento e selezione/classificazione di materie prime ad elevata purezza. Caratterizzate da un diametro uniforme (tolleranza entro ±0,02 mm) e da un'eccellente rotondità, sono ampiamente utilizzate nel packaging BGA e nella saldatura microelettronica per migliorare la precisione del packaging e garantire connessioni affidabili tra chip e scheda.
Composte principalmente da stagno, argento e rame ad alta purezza, queste sfere vengono utilizzate nelle schede madri dei server, nelle schede grafiche e nei chip degli smartphone. Prevengono guasti di connessione nei packaging BGA, giunzioni di saldatura irregolari nella saldatura microelettronica e interferenze di segnale nella saldatura dei chip ad alta frequenza.

1. Micro-ponti sotto il chip
Le sfere di saldatura BGA sono microsfere metalliche disposte sotto il chip, con un diametro tipicamente compreso tra 0,2 e 0,76 millimetri. Queste sfere in lega di stagno funzionano come ingegneri di ponti in miniatura: si fondono durante il funzionamento e si solidificano in connessioni elettriche permanenti durante il raffreddamento. Rispetto ai pin tradizionali, questo design consente centinaia di punti di connessione per chip con un passo fino a 0,4 millimetri.
2. Maestri termodinamici danzanti
Le sfere di saldatura mostrano proprietà notevoli durante la saldatura a riflusso:
Controllo della tensione superficiale: si allineano automaticamente ai cuscinetti come gocce di mercurio quando sono fusi
Capacità di autocorrezione: piccoli disallineamenti vengono riallineati automaticamente tramite flusso di metallo liquido
Corrispondenza dell'espansione termica: le formulazioni speciali delle leghe attenuano le differenze di espansione/contrazione termica tra chip e PCB
3. Piccole sfere, grande impatto
Questo progetto apporta tre cambiamenti rivoluzionari:
- 60% aumento dell'utilizzo dello spazio, consentendo smartphone più sottili
- Distanze di trasmissione del segnale più brevi, che consentono velocità di elaborazione più elevate
- La maggiore resistenza agli urti riduce significativamente i tassi di guasto nell'elettronica automobilistica
La cosa più interessante è che la tensione superficiale delle sfere di saldatura in fusione forma naturalmente archi perfetti. Questa proprietà ottica intrinseca viene persino sfruttata per calibrare alcuni sensori.
Il BGA è un package a montaggio superficiale in cui delle protuberanze sferiche sostituiscono i pin in una disposizione a matrice sul retro del PCB. I chip LSI vengono montati sul lato frontale del PCB, quindi sigillati utilizzando resina stampata o metodi di potting.
Caratteristiche
• Numero maggiore di pin e passo più fine con ingombro di assemblaggio ridotto
• Prestazioni termiche ed elettriche superiori
• Compatibile con i processi SMT
• Bassi costi di produzione e alta affidabilità
Luoyang Qiancai Industrial fornisce elevata purezza Sfere di saldatura BGA, assicurando che le sfere di saldatura soddisfino i requisiti di precisione richiesti.